《表1 Ti N薄膜的沉积工艺参数》
 提示:宽带有限、当前游客访问压缩模式
提示:宽带有限、当前游客访问压缩模式
本系列图表出处文件名:随高清版一同展现
《辉弧放电过渡区间靶电流密度对TiN薄膜结构及性能的影响》
Note:Ipd-target peak current density;Ut-target voltage;w-pulse width;f-frequency;Us-bias voltage;P-chamber pressure
实验采用MSIP-019型闭合场非平衡磁控溅射离子镀系统(真空腔容积为Φ450 mm×H400 mm)进行薄膜制备,平面矩形磁控阴极选取纯度99.9%的Ti靶(300 mm×100 mm),工作气体为99.9%纯度的氮气。基体选取M2高速钢(W6Mo5Cr4V2)和P型(100)单晶硅片,放置在与靶材呈90°且靶基距为150 mm处。实验采用频率为40 Hz的宽脉冲电源恒流控制模式,分别在气体放电伏安特性处于辉弧放电过渡区间的3组靶电流密度条件下沉积Ti N薄膜(即普通磁控溅射离子镀通常的靶电流密度0.02 A·cm-2、伏安特性由欧姆向反欧姆过度的拐点处靶电流密度0.23 A·cm-2、辉弧过渡区间接近弧光放电时的靶电流密度0.38A·cm-2),如图1所示。沉积过程中,首先用Ar+轰击清洗试样表面10 min,再预沉积Ti过渡层5 min,最后沉积Ti N薄膜35 min,具体实验参数如表1所示。该沉积过程属于反应溅射沉积,其反应过程如下[12]:
| 图表编号 | XD0011235300 严禁用于非法目的 |
|---|---|
| 绘制时间 | 2018.04.01 |
| 作者 | 郝娟、蒋百灵、杨超、吴祥、张静、丁郁航 |
| 绘制单位 | 西安理工大学微弧电子学实验室、西安理工大学微弧电子学实验室、西安理工大学微弧电子学实验室、西安理工大学微弧电子学实验室、西安理工大学微弧电子学实验室、西安理工大学微弧电子学实验室 |
| 更多格式 | 高清、无水印(增值服务) |
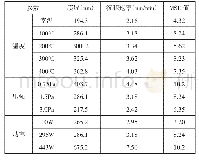
![表1 沉积工艺参数对光学薄膜材料的影响(k<10-4)[16]](http://bookimg.mtoou.info/tubiao/gif/JGDJ202013003_01000.gif)



