《表1 封装各材料的热膨胀系数》
封装基板的阻焊层和铜层做可靠性试验时出现剥离分层,是由于产品各种材料的CTE不匹配使产品出现翘曲变化,而当不同材料结合处受的剪切力或者剥离力大于材料间的粘合力时,材料结合层就会发生剥离分层,如表1所示,阻焊层的玻璃化转变温度Tg为100℃,当温度低于Tg时,CTE为60×10-6 K-1,当温度高于Tg时,CTE为130×10-6 K-1;模塑料的Tg为130℃,当温度低于Tg时,CTE为10×10-6 K-1,当温度高于Tg时,CTE为45×10-6 K-1。
| 图表编号 | XD0030513800 严禁用于非法目的 |
|---|---|
| 绘制时间 | 2019.02.20 |
| 作者 | 杨建伟 |
| 绘制单位 | 广东气派科技有限公司 |
| 更多格式 | 高清、无水印(增值服务) |
 提示:宽带有限、当前游客访问压缩模式
提示:宽带有限、当前游客访问压缩模式


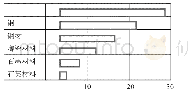
![表1 800℃下常见电解质材料的热膨胀系数和离子电导率[28]](http://bookimg.mtoou.info/tubiao/gif/TCXB202006006_02300.gif)
![表1 FCBGA封装中各组件的材料参数[17]](http://bookimg.mtoou.info/tubiao/gif/NGZK202004005_00500.gif)
